Azotek galu jest półprzewodnikiem z szeroką przerwą zabronioną. Przyrządy wykonane z GaN mogą poprawnie pracować w temperaturze wyższej niż przyrządy krzemowe. Półprzewodniki potrójne AlGaN i InGaN mają inną szerokość przerwy zabronionej niż GaN i na granicach warstw GaN/AlGaN InGaN/AlGaN pojawia się dwuwymiarowa warstwa ładunku, którego nośniki mogą osiągać dużą prędkość. Węglik krzemu (SiC), który jest powszechnie stosowany w energoelektronice i ma jeszcze lepsze parametry cieplne niż GaN, nie może posłużyć do konstrukcji tranzystorów szybkich, ponieważ w tym systemie nie można uzyskać dwuwymiarowego gazu elektronowego na granicy półprzewodników o różnym składzie. Podobnie jak w materiale SiC w systemie GaN/AlGaN pole krytyczne, przy którym występuje zjawisko przebicia lawinowego osiąga dużą wartość, co umożliwia konstrukcję wydajnych przyrządów mocy. Zatem azotek galu jest idealnym materiałem do wykonania mikrofalowych przyrządów mocy.
Wadą systemu GaN/AlGaN jest brak monokrystalicznych podłoży GaN o dużej średnicy, dobrej jakości i niskiej cenie. Obecnie główny rynek przyrządów z GaN/AlGaN to białe źródła światła. Diody elektroluminescencyjne z GaN/AlGaN są wykonywane na podłożach krzemowych o średnicy 200 mm i 300 mm. Dioda emituje światło niebieskie lub ultrafioletowe, którego konwersję realizuje warstwa luminoforu fosforowego. W elektronice mikrofalowej, cywilnej i wojskowej przyrządy z GaN/AlGaN są wykonywane na podłożach z węglika krzemu o średnicy 125 mm i 150 mm dlatego, że jakość krystaliczna warstw na podłożu SiC jest znacznie lepsza niż na podłożu krzemowym. W ITME opracowano technologię trzyrządów HEMT z GaN/AlGaN na podłożach szafirowych i podłożach z węglika krzemu.
Szafir jest tanim i dobrze poznanym podłożem dla systemu GaN/AlGaN, ale źle przewodzi ciepło. Wiele elementów docelowej technologii GaN/AlGaN na podłożu SiC można opracować na podłożach szafirowych. Zarówno przyrządy HEMT jak układ scalony MMIC opisane w tym raporcie wykonano na podłożu szafirowym.
Wyniki
W pierwszej fazie opracowania do żadnej z warstw struktury epitaksjalnej nie wprowadzano domieszki. Ładunek elektryczny powstał na granicy GaN/AlGaN wskutek efektów piezoelektrycznych.
Tranzystory bez intencjonalnego domieszkowania warstwy AlGaN miały bramkę o szerokości równej 100 µm i długości 500 nm. Tranzystory wytworzono na podłożach ze strukturą epitaksjalną wyhodowaną w ITME i w laboratorium Politechniki Wrocławskiej. Wyniki na obu rodzajach podłoża były takie same.
Na rysunkach 1 i 2 przedstawiono fotografię płytki z tranzystorami oraz pojedynczy tranzystor.
Charakterystyki wyjściowe I-V oraz zależność transkonduktancji gm od polaryzacji bramki przedstawiono na rysunkach 3 i 4. Osiągnięto gęstość prądu ok. 500 mA/mm oraz transkonduktancję 170 mS/mm.
 | 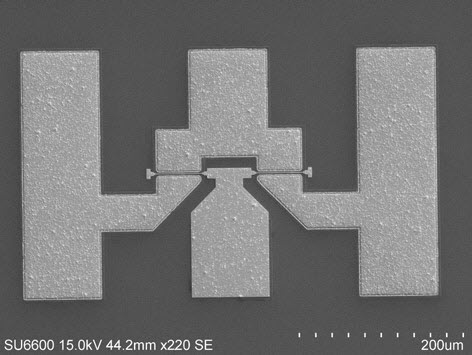 |
| Rys. 1. Widok ogólny płytki z tranzystorami | Rys. 2. Struktura dwubramkowego tranzystora |
Rys. 3. Charakterystyki wyjściowe tranzystora HEMT
Rys. 4. Transkonduktancja tranzystora HEMT
W celu zwiększenia gęstości prądu dren-źródło wprowadzono domieszkowanie warstwy AlGaN, a równocześnie zwiększono szerokość bramki do wartości 300 μm. Ponadto zaprojektowano asymetryczne położenie bramki w kanale tranzystora w celu równoczesnego uzyskania poprawy parametrów mikrofalowych i osiągnięcia wysokiej wartości napięcia przebicia dren-źródło. Na rysunku 5 przedstawiono pomiar odległości metalizacji bramki od metalizacji drenu.
W wyniku zmiany konstrukcji i technologii uzyskano wysoką wartość napięcia przebicia tranzystora, a ponadto gęstość prądu nasycenia dren-źródło wzrosła z wartości 500 mA/mm do wartości 700 mA/mm.
Na rysunku 6 przedstawiono wyniki pomiarów napięcia przebicia dren-źródło w różnych miejscach płytki. Przy wartości prądu 10-4 A napięcie przebicia dren-źródło wynosi 80 V.
Rys. 5. Pomiar wymiarów krytycznych tranzystora. Odległość dren-bramka wynosi 1,9 μm, długość bramki 440 nm, odległość źródło bramka ok. 600 nm
Rys. 6. Pomiar napięcia przebicia dren-źródło przy napięciu bramka-źródło -10 V
Pomiary wykonywano w temperaturze pokojowej, metodą „on-wafer” na stanowisku do pomiarów ostrzowych firmy Cascade. Stosowano analizator sieci N5230A oraz sondy GSG 200 i GSG 150. Mierzono parametry macierzy rozproszenia, [S], w punkcie pracy UDS=5 V, ID≈ IDSS/2. Z tych pomiarów wyznaczano:
Dla tranzystorów o długości kanału 4 µm częstotliwość fT wynosiła 16 GHz, dla tranzystorów o długości kanału 1,6 µm otrzymano fT = 20 GHz. Wyniki pomiarów mikrofalowych odpowiadające tym wariantom konstrukcyjnym syntetycznie przedstawiono na rysunkach 7 i 8.
Rys. 7. Określenie częstotliwości fT ≈ 16 GHz z charakterystyki H21 dla tranzystora z odległością S-D równą 4 μm
Rys. 8. Określenie częstotliwości fT ≈ 20 GHz z charakterystyki H21 dla tranzystora z odległością S-D równą 1,6 μm
W wyniku zmiany konstrukcji i technologii tranzystora uzyskano nie tylko wzrost wartości napięcia przebicia i wzrost gęstość prądu nasycenia, ale równocześnie zwiększenie wszystkich częstotliwości granicznych.
Na rysunku 9 przedstawiono pomiary mikrofalowe następujących parametrów: MSG (maximum stable gain), Gmax (maximum available gain), UPG (unilateral power gain), współczynnik Rollet’a k, moduły parametrów│H21│oraz │S21│.
Rys. 9. Wyniki pomiarów parametrów mikrofalowych MSG, GMAX, UPG,│H21│,│S21│oraz k – kryterium stabilności Rollet’a
Zaprojektowano i wykonano pierwszy w Polsce układ MMIC (microwave integrated circuit) z tranzystorami HEMT z GaN/ AlGaN. Zrealizowano klucz typu SPDT (single-pole doublethrow) stosowany zazwyczaj w układach transciever’ów (klucz nadawanie-odbiór). Schemat układu przedstawiono na rys. 10:
Rys. 10. Schemat układu SPDT.
Transmisja sygnału z wejścia na wyjście pierwsze jest włączona jeżeli tranzystor T1 jest otwarty, a tranzystor T3 zamknięty (sygnał sterujący S1 jest równy 0 V, a sygnał S2 równy -10 V). Równocześnie tranzystor T2 jest zamknięty (wyjście drugie jest odizolowane od wejścia). Dla zwiększenia wartości izolacji tranzystor T4 jest otwarty i zwiera do masy sygnał wejściowy, który przechodzi przez zatkany tranzystor T2. Sterowanie jest synchroniczne. Sygnały sterujące S1 i S2 są na przemian równe 0 V i -10 V i ustalają potencjały bramek tranzystorów.
Na rysunku 11 przedstawiono fotografię zrealizowanej struktury układu scalonego.
Rys. 11. Cztery układy MMIC
Szerokości wszystkich bramek są równe 150 µm. Odległość dren-źródło wynosi 3 µm. Długość bramki wynosi 440 nm.
Przy pomocy sond mikrofalowych typu GSG, GS i SG firmy Cascade oraz analizatora sieci N5230A zmierzono straty wtrącenia i izolację układu.
Straty wtrącenia i izolacja (insertion loss, isolation) są zdefiniowane następująco: IL = -20 db (│S21│). Przy odwróceniu kierunku transmisji IL = -20 db (│S12│). Na rysunkach 12 i 13 przedstawiono wyniki pomiarów strat i izolacji układu w pięciu punktach płytki o średnicy 2”.
Dla zakresu częstotliwości 100 MHz-4 GHz straty wtrącenia są mniejsze niż 2 dB natomiast izolacja jest lepsza niż 23 dB.
Przedstawiony na rysunku 14 parametr S22 jest impedancją tranzystora T4 zwierającego sygnał.
Rys. 12. Pomiar strat wtrącenia i izolacji pięciu układów, transmisja w kierunku WE-WY1
Rys. 13. Pomiar strat wtrącenia i izolacji pięciu układów, transmisja w kierunku WY1-WE
Rys. 14. Parametr S22 dwóch układów MMIC w stanie izolacji wyjścia, pomiar w paśmie 0–10 GHz
Impedancja jest znormalizowana i odpowiada rezystancji kanału równej 20 Ω. Szerokość bramki tranzystora wynosi 150 µm, a zatem osiągnięto poziom technologii, który można syntetycznie określić parametrem rezystancji włączenia tranzystora równej 3 Ω na 1 mm szerokości bramki. Tranzystory transmisyjne T1 i T2 mają taką samą budowę. Wiadomo, że parametr S21 = S12 dwuwrotnika składającego z impedancji szeregowej Z jest równy 2Z0 /(2Z0 + Z), gdzie Z0 jest impedancją charakterystyczną linii.
W wyniku prostego rachunku dla Z = 20 Ω mamy: |S21| = |S12| = 1.584 dB. Ten wynik odpowiada zmierzonej wartości strat wtrącenia.
Straty wtrącenia komercyjnych układów MMIC są mniejsze niż 1 dB, ale osiągane są dla tranzystorów o szerokości bramki ok. 500 μm i większej [1].
Jeżeli zwiększono by trzykrotnie szerokość bramki tranzystorów w opisywanym układzie (do wartości 450 µm), to wtedy |S21| = |S12| = 0,588 dB.
Przedstawiony układ MMIC jest zatem demonstratorem technologii, przy pomocy której można wykonać układy scalone o parametrach na poziomie komercyjnym.
Pomiar izolacji był wykonywany w niekorzystnych warunkach, ponieważ nie można ustawić równocześnie obok siebie dwóch sond GS i SG w kontakcie z polami WY1 i WY2 (ze względu na rozmiary sond). Zatem rozwarcie jednego z wyjść miało wpływ na pomiar. Ponadto widoczne oscylacyjne zaburzenia przebiegu charakterystyk (szczególnie charakterystyk izolacji) wynikają z braku filtrów w układach polaryzacji bramek tranzystorów (sygnały S1 i S2). Do kontaktu z polami S1 i S2 zastosowano sondy ostrzowe. W wypadku montażu układu na laminacie można uzyskać stłumienie tych oscylacji [2].
Wyestymowany z charakterystyk wyjściowych tranzystora [1] poziom mocy układu MMIC P1dB≈200 mW.
Podsumowanie
Opracowano tranzystory, które pracowały w pasmach S i X, gdzie zmierzono parametr MSG/MAG o wartościach odpowiednio 16 i 10 dB. Dla zoptymalizowanej konstrukcji i technologii tranzystora określono częstotliwość fT równą 30 GHz i częstotliwość fMAX równą 30 GHz. Ponadto stwierdzono, że częstotliwość, dla której unilateralne wzmocnienie mocy równa się jeden wynosi 30 GHz, a częstotliwość dla której parametr |S21| równa się jeden wynosi 20 GHz. Uzyskano napięcie przebicia dren-źródło równe 80 V dla wartości prądu przebicia 10-4A.
Uzyskano gęstość prądu nasycenia dren-źródło równą 700 mA na 1 mm szerokości kanału.
Uzysk tranzystorów wynosił 70%. Otrzymano ok. 3000 dobrych przyrządów z jednej płytki o średnicy 2”.
Stwierdzono, że statystyki pomiarów stałoprądowych i mikrofalowych mają małe odchylenia i jest możliwa realizacja układów scalonych.
Opracowano pierwszy w Polsce mikrofalowy monolityczny układ scalony (MMIC) typu SPDT (single pole double throw). W paśmie 0–4 GHz straty wtrącenia są mniejsze niż 2 dB, a izolacja lepsza niż 23 dB. Wykazano, że po zmianie konstrukcji układu i stosując tę samą technologię można uzyskać straty wtrącenia mniejsze niż 1 dB. Przedstawiony układ MMIC jest demonstratorem technologii, przy pomocy której można wykonać układy scalone o parametrach na poziomie komercyjnym.
Obecnie zoptymalizowany wariant konstrukcyjny tranzystora, a także układ MMIC jest wykonywany na podłożach z węglika krzemu.
Dziękujemy następującym osobom za przeprowadzenie niezależnych pomiarów mikrofalowych na terenie PW i PWr: Wojciech Wojtasiak (PW Instytut Radioelektroniki), Bogdan Paszkiewicz (WEMiF PWr).
LITERATURA
[1] V. Kaper, R. Thompson, T. Prunty, J. R. Shealy, “Monolithic AlGaN/GaN HEMT SPDT switch”, 12th GAAS Symposium, Amsterdam 2004.
[2] Qian Li, at. all, “Dual-gate GaN-HEMT SPDT switch with high isolation”, 2014 IEEE Int. Conference on Communication Problem –Solving (ICCP), pp. 13–137.
| REKLAMA |

| REKLAMA |